

通过薄膜计量提高薄膜质量

马尔文帕纳科为基于层结构的微电子和光电子器件的开发和生产控制提供计量解决方案。

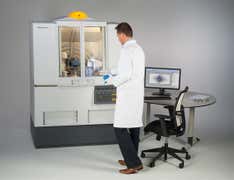

基于 X 射线方法的薄膜计量工具,如 XRD、XRR 和 XRF,快速且无破坏性。 它们经过验证,能够对薄层、异质结构和超晶格系统的重要材料参数进行离位分析,从而降低至纳米级。
产生的信息对于优化薄膜质量、提高生产效率并降低成本至关重要。