Stratos
用于薄膜的厚度和成份分析
用于薄膜的厚度和成份分析
薄膜和多层材料普遍存在。 其应用不胜枚举,从珠宝、镀层钢或其他金属到集成电路等等。 在薄膜和多层膜的生产中,准确控制厚度和成份通常是必须的。
XRF 使出色的可重复性与非破坏性测量相结合,是非常有价值的薄膜成分和厚度分析技术。 通过 XRF 测量厚度的可重复性可以达到 ±1 Ångstrom。
传统上,用于薄膜分析的 XRF 校准过程一直具有挑战性,特别是对于多层结构。 通常校准样品需要具有与待分析样品类似的结构和成份。 这些校准样品通常是昂贵且难以获得的。
Stratos 通过大大简化和提高 XRF 校准过程的灵活性,进一步提高了薄膜测量过程中 XRF 的价值。 Stratos 允许使用与未知物不同的校准样品,甚至允许使用块状材料来校准薄膜和多层膜的分析。
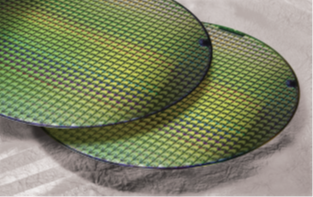
Stratos 内含 Virtual Analyst,可以模拟对复杂结构的 XRF 响应,立即显示哪种荧光线最适合用于测量您的多层材料的相关厚度和浓度水平的变化。 这简化了薄膜分析的方法设置。
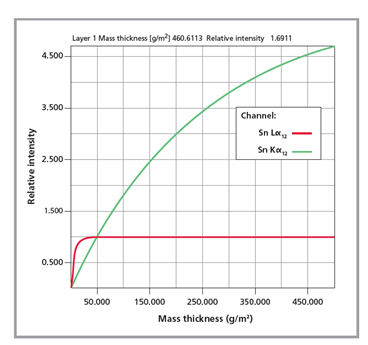
Stratos 模块内含马尔文帕纳科XRF 仪器的软件许可证,包括 Zetium、Axios 或 MagiX 以及 Epsilon 台式系列。
它可以与 Omnian 无缝结合。 对于已安装 Omnian 的系统,使用 Stratos 将 Omnian 设置直接用于薄膜分析。
对于未安装 Omnian 的系统,Omnian 设置样品仍可用于设置 Stratos。
该模块可以与新系统一起交付,也可以在运行 SuperQ 或 Epsilon 软件的现有仪器上进行改装。