
Empyrean 锐影系列
多用途 X 射线衍射仪
薄膜、表面和界面

X 射线反射仪 (XRR) 是一种分析技术,用于使用 X 射线的总外部反射效应来研究薄层结构、表面和界面。 反射仪用于表征磁性、半导体和光学材料中的单层和多层结构及涂层。
在反射实验中,样品的 X 射线反射是在临界角周围测量的。 这在掠入射角周围进行。 低于总外部反射的临界角时,X 射线仅穿透样品几纳米。 高于临界角时,穿透深度会迅速增加。 在电子密度发生变化的每个界面上,都会反射部分 X 射线光束。 这些部分反射的 X 射线光束的干扰会产生在反射实验中观察到的振荡模式。 从这些反射曲线中,可以确定厚度和密度、界面和表面粗糙度等层参数,而不考虑每层的结晶度(单晶、多晶或无定形)。
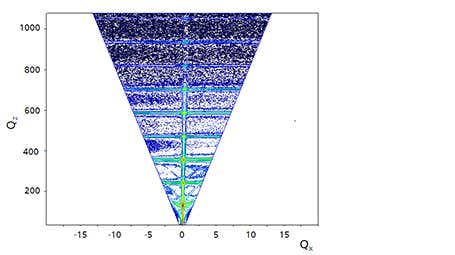

多用途 X 射线衍射仪
可以在马尔文帕纳科的 Empyrean 系统上执行反射实验。
可使用 Reflectivity 软件包中实施的一些列自动拟合程序来分析反射仪数据。 作为马尔文帕纳科 XRD 软件系列的一部分,Reflectivity 采用 XRDML 数据格式。 通过允许模拟到实验镜面 X 射线反射曲线的自动拟合,Reflectivity 使反射仪适用于普通用户,而以前只能用于高度专业的用户。